随着生成式AI的飞速发展,智能(AI)眼镜正从科幻走向现实,成为人们生活中的得力助手。据维深信息Wellsenn XR数据报告[1],2024年全球AI眼镜销量为152万台,2025年将激增至350万台,同比增长130%。
在这令人兴奋的背后,一场技术挑战正在上演。CMOS图像传感器(CIS)是AI眼镜之眼,被给予越来越多的想象空间,但CIS必须在“小”与“强悍”间博弈。如何在不足1cm2的狭窄镜框内,不到40克的重量红线下,容纳更强大的影像能力?这正是行业必须直面的技术命题。
格科创新的高性能CIS封装技术――TCOM(Tiny Chip On Module)封装,正是为此而生。

AI眼镜结构拆解示意
小型化:TCOM封装技术的突破
TCOM是基于格科高性能COM封装技术升级而来,专为空间敏感应用研发。COM封装技术可媲美高端COB(Chip On Board)封装,具备更优异的光学系统性能和背压可靠性等。在长期的量产实践中,受到客户高度认可,目前累计出货总量超过5亿颗。
在此基础上,TCOM升级结构与工艺,在有限空间内构建高性能影像模组。相比同规格COB封装芯片,模组尺寸缩小10%。而且,与行业现行的小型化方案相比,具备显著的成本优势和更高的背压可靠性。
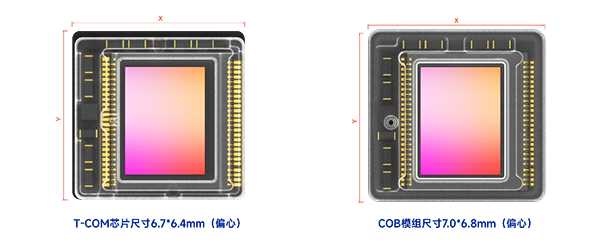
GC13B0 TCOM&COB芯片尺寸对比
格科如何实现这一突破性设计的呢?
现行的小型化CIS封装方案,面临着成本与背压可靠性的双重难题。该方案基于COB结构,采用特殊Molding模具和设备,将元器件、芯片、线路板等铸模密封。虽然可缩小模组尺寸,且结构强度高,但是随之而来的是较高的成本。同时,因CIS直接贴装在电路板,对背压更敏感,SFR即图像解析力更易受到影响。
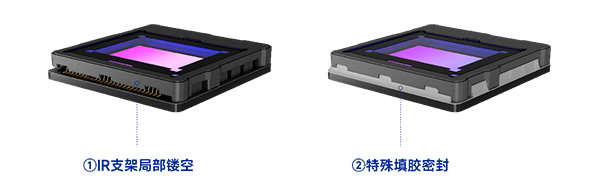
COB、现有小型化方案、TCOM对比
而TCOM在实现小型化设计的同时,兼具了性能和成本上的优势。首先,改善支架设计。在连接CIS与FPC电路板的金线两侧,IR支架局部镂空,宽度缩短约10%。然后采用独特的填胶工艺和设备,在元器件放置两侧、IR支架与元器件之间,按一定角度完成填胶密封。

TCOM工艺步骤示意
通过上述独特设计,TCOM模组既缩短了长宽,又不牺牲结构强度,可适配AI眼镜“镜框即镜头”的紧凑设计,为设备预留更多空间布局其他元器件,让“全天候无感佩戴”成为可能。
从AI眼镜到手机,拓展更多可能性
TCOM技术的应用场景远不止AI眼镜。智能手机、平板电脑等终端毫米必争,TCOM封装技术带来了新的可能。
以手机为例,TCOM可进一步缩小前置摄像头模组,使前摄位置更灵活,可贴近屏幕边框设计,带来更佳的全面屏效果;对于后摄,TCOM可改善模组高度,减少相机模组凸起,使手机更纤薄,进一步提升整机竞争力。
空间越紧凑,散热越关键,针对这一难题,格科研发出了具有散热优势的COM方案。
当手机持续拍摄高分辨率、高帧率影像时,往往容易发烫。若散热不佳,将会影响设备稳定性和安全性。统计结果表明[2],手机内部电子器件的温度每上升10℃,其可靠性就会降低50%。值得注意的是,在所有引发电子器件失效的因素中,高温引发的故障占比高达55%。
COM散热方案在传统DA胶散热材料上,增加了高效的导热硅凝胶,进一步增强散热效果。实测数据显示,基于50MP 1.0μm CIS模组在4K 60fps模式下,COM封装相对COB能够降低约5°C的模组温度,相当于使用手机时外置了一个散热风扇!
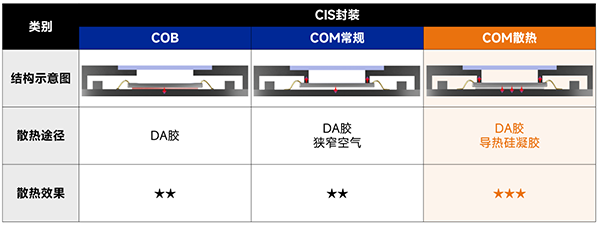
COM散热方案结构示意与各方案散热效果对比
在AI眼镜、智能手机等终端中,每一克的重量优化、每毫米级的空间释放、每降温1度,都是用户体验的跃升。格科COM系列封装方案,重新定义了CIS封装的新标准,让微型化、散热、高性能、高可靠性实现共生。
或许不久的将来,当我们戴上那副“无感存在” 的智能眼镜,看到的不仅是虚实融合的世界,更是技术与用户体验共振的未来――足够智能,也足够轻盈。
目前,格科500万像素CIS已在AI眼镜项目量产。未来,格科将持续以CIS为核心,搭配COM系列等高性能CIS封装方案,为设备装上更轻薄、更智能的 “眼睛”。

